NeoPAC®
NeoPAC®은 50여건의 특허등록을 한 이미지센서 패키징 기술로,
센서업계 선두회사들인 일본 Sony, 미국 TI, 중국 Galaxy Core, 한국 SK hynix 등
다수 고객사에 이미지 센서 패키징 서비스를 제공하고 있습니다.
GLOBAL COMPANY iWIN PLUS
NeoPAC® Encap
NeoPAC® Encap 이란 ?
NeoPAC® Encap은 기존 NeoPAC® II Normal 구조에 다음과 같은 Epoxy 보강구조를 추가하여
신뢰성을 한단계 Upgrade시킨 NeoPAC® 제품을 말합니다. ( 아래 Schematic Section View 참조 )
- Silicon Sensor Chip의 측면 및 하면을 에워싸는 Epoxy Encapsulation 구조
- Sensor Chip과 기판 사이의 Flip Chip Solder Joints를 둘러싸는 Epoxy 보강(Underfill) 구조
- 주변부 Outer Solder Balls을 둘러싸는 Epoxy 보강 구조를 가지며,
- 추가로, NeoPAC® Encap 은 패키지 상면 Glass Filter를 둘러싸는 Epoxy 보강 구조도 가능합니다
NeoPAC® Encap 단면도
NeoPAC® Normal

NeoPAC® Encap 하면

NeoPAC® Encap 상하면


NeoPAC® Encap 이미지/단면도
NeoPAC® Encap 단면구조
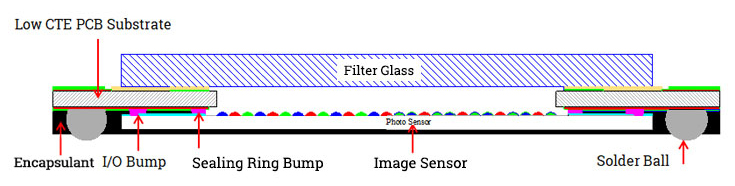
NeoPAC® Encap 제품의 전/후면
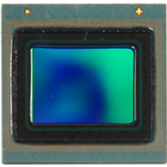
전면

후면
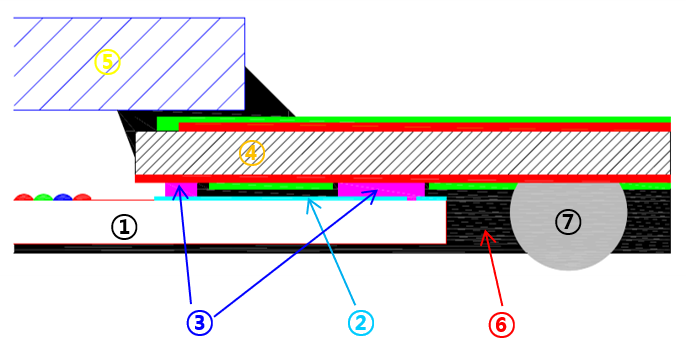
| No | Description | No | Description |
|---|---|---|---|
| ① | Photo Sensor | ⑤ | Glass / Filter Glass |
| ② | SBL (Stress Buffer Layer) | ⑥ | Encapsulation Material |
| ③ | Bump (Sealing Ring, Inner Joint) | ⑦ | Solder Ball |
| ④ | PCB Substrate |
NeoPAC® Encap 구조
Low CTE PCB Substrate ( NeoPAC® II 와 동일 )
- Low CTE PCB가 적용됩니다.
- 2층의 금속 배선층과 2층의 금속 보호막층을 가지는 Substrate 입니다.
- 목적에 따라 다층구조도 가능합니다.
- 빛을 투과하기 위해 Pixel 영역은 Opening이 되어 있습니다.
- Core 두께 : 60um / 100um / 200um /.....
Filter Glass ( NeoPAC® II 와 동일 )
- PCB Substrate위에 접합되어 있습니다.
- Cavity영역을 밀봉하여 밀봉특성을 제공합니다.
- 두께 : 100um / 145um / 210um / 300um / 400um / 500um / 700um
이미지센서 Chip ( NeoPAC® I, NeoPAC® II 와 동일 )
- SBL (Stress Buffer Layer) 층을 가집니다.
- 무연 솔더범프가 형성 됩니다.
- 센서 Al Pad위 Inner Joint를 위한 범프 형성
- Pixel 영역을 보호하기 위한 주변 Closed Loop Sealing Ring 범프 형성
Flip Chip Solder Joint / TLP Bonding ( NeoPAC® I, NeoPAC® II와 동일 )
- 기판과 이미지센서 Chip 접합은 Flip Chip Solder Joint 접합방식
- 접합 신뢰성이 아주 우수한 TLP Bonding공법 적용
이미지센서 Chip 주변에 Solder Ball이 배치 됩니다. ( NeoPAC® I, NeoPAC® II와 동일 )
- Module PCB위에 Board Assembly(SMT)후 전기적으로 연결됩니다.
- 높은 신뢰성(Board Level Reliability)이 요구되는 제품(Automotive…)은 370um, 450um ball 등의 큰 Ball이 적용됩니다.
Epoxy Encapsulation
- Sensor 측면, 하면
- Flip Chip Solder Joint 주변부
- Solder Ball 주변
NeoPAC® Encap 제품군
| Image Sensor for Automotive (AEC-Q100) | ||||
|---|---|---|---|---|
 |
 |
 |
 |
 |
 |
 |
 |
 |
 |
장점
Sensor Chip의 측면 및 하면을 통한 빛의 침투를 차단
- NeoPAC® Encap은 Epoxy 수지로 Sensor Chip을 밀봉한 구조를 가지고 있어서, 패키지가 빛에 노출되어 있어도 빛이 차단됩니다.
- 카메라 모듈 제작시, Lens Holder를 NeoPAC® 패키지 위에 올릴 수 있습니다.
그래서, COB Module 보다 더 작은 Camera Module을 만들 수 있습니다.
Automotive Application을 위한 견고한 고신뢰성 패키지 제품
- 차량용 반도체 신뢰성 규격 “AEC-Q100”, Grade 2 조건을 만족합니다.
- NeoPAC® Encap은 현 NeoPAC® Normal 구조에서 Flip Chip Solder Joint부를 Epoxy로 보강하는 구조를 가집니다.
- 또한 NeoPAC® Encap은 주변부에 있는 Outer Solder Ball도 Polymer로 보강하는 구조를 가집니다.
- 현 NeoPAC® Normal 구조대비 신뢰성이 대폭 개선됩니다.
특히, Module상의 Board Level TC 수명이 대폭 개선됩니다.
Mobile Application에서의 Drop Test Performance 개선
- NeoPAC® Encap은 제품 하부의 Sensor Chip, Flip Chip Solder Joint, Outer Solder Ball 등이 Epoxy로 밀봉이 된 구조를 가지고 있어서, 기존 NeoPAC® Normal 제품대비 견고하며, 특히 Drop Test 성능이 현격히 개선됩니다.
Optical Coating
- NeoPAC® II 와 동일한 Optical Coating 옵션을 제공합니다.
미래의 패러다임 변화를 감지하여
효과적인 패키징 서비스를 제공하는 아이윈플러스입니다.
효과적인 패키징 서비스를 제공하는 아이윈플러스입니다.




